结束前工序的每一个晶圆上,都连接着500~1200个芯片(也可称作Die)。为了将这些芯片用于所需之处,需要将晶圆切割(Dicing)成单独的芯片后,再与外部进行连接、通电。此时,连接电线(电信号的传输路径)的方法被称为引线键合(Wire Bonding)。其实,使用金属引线连接电路的方法已是非常传统的方法了,现在已经越来越少用了。近来,加装芯片键合(Flip Chip Bonding)和硅穿孔(Through Silicon Via,简称TSV)正在成为新的主流。加装芯片键合也被称作凸点键合(Bump Bonding),是利用锡球(Solder Ball)小凸点进行键合的方法。硅穿孔则是一种更先进的方法。为了了解键合的最基本概念,在本文中,我们将着重探讨引线键合,这一传统的方法。
一、键合法的发展历程

图1. 键合法的发展史:引线键合(Wire Bonding)→加装芯片键合(Flip Chip Bonding)→硅穿孔(TSV)
为使半导体芯片在各个领域正常运作,必须从外部提供偏压(Bias voltage)和输入。因此,需要将金属引线和芯片焊盘连接起来。早期,人们通过焊接的方法把金属引线连接到芯片焊盘上。从1965年至今,这种连接方法从引线键合(Wire Bonding),到加装芯片键合(Flip Chip Bonding),再到TSV,经历了多种不同的发展方式。引线键合顾名思义,是利用金属引线进行连接的方法;加装芯片键合则是利用凸点(bump)代替了金属引线,从而增加了引线连接的柔韧性;TSV作为一种全新的方法,通过数百个孔使上下芯片与印刷电路板(Printed Circuit Board,简称PCB)相连。
二、键合法的比较:引线键合(Wire Bonding)和加装芯片键合(Flip Chip Bonding)
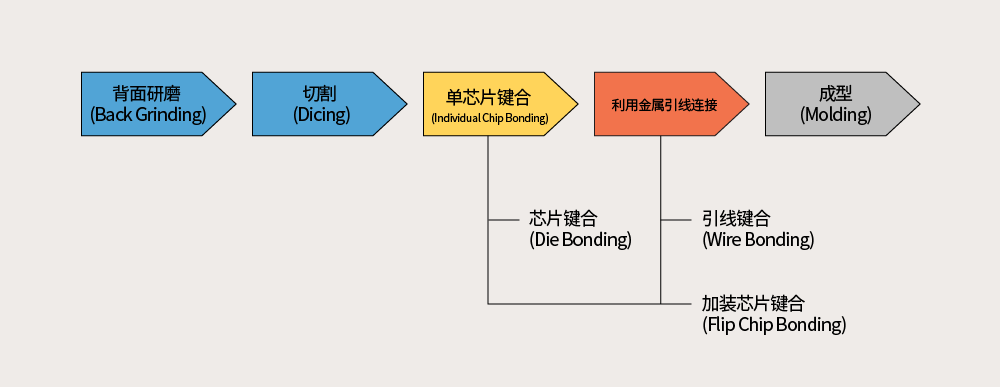
图2. 引线键合(Wire Bonding) VS加装芯片键合(Flip Chip Bonding)的工艺
芯片键合,作为切割工艺的后道工序,是将芯片固定到基板(substrate)上的一道工艺。引线键合则作为芯片键合的下道工序,是确保电信号传输的一个过程。与引线键合相似的另一种连接方法为加装芯片键合(请参见<芯片键合,在封装基板上装配芯片的工艺(Die bonding,Process for place a chip on a Package Substrate)>),两者都是使用直径很小的金属物体来连接芯片中的焊盘和PCB上的焊盘(在引线框架下,仅使用于引线键合)的。相比之下,利用金属引线进行连接的引线键合法有如下几个缺点:金属引线比凸点要长,且直径更小,因此传输电信号耗时长;且由于金属引线的高阻抗(impedance),信号很容易失真。不仅如此,由于焊颈(solder neck)容易断开、且结合强度相对较弱,因此拉伸强度相对较差。相反,加装芯片键合法虽然操作连接器小锡球有些复杂,但在连接可靠性和电信号传输等方面却有很多优势。
三、引线键合(Wire Bonding)是什么?
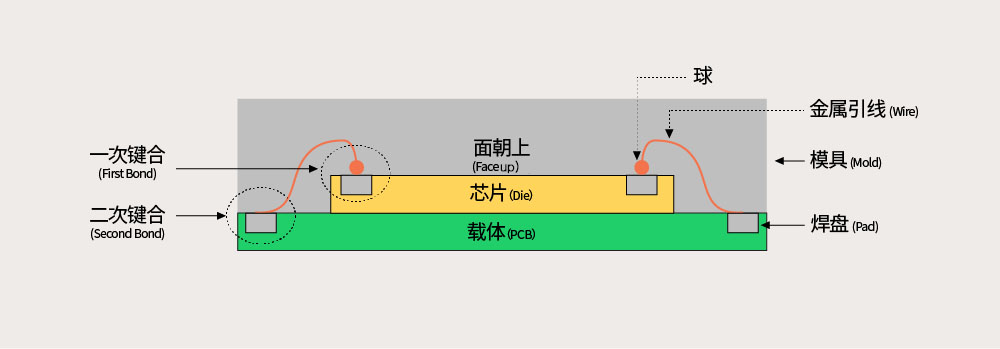
图3. 引线键合的结构(载体为印刷电路板(PCB)时)
引线键合是把金属引线连接到焊盘上的一种方法,即是把内外部的芯片连接起来的一种技术。从结构上看,金属引线在芯片的焊盘(一次键合)和载体焊盘(二次键合)之间充当着桥梁的作用。早期,引线框架(lead frame)被用作载体基板,但随着技术的日新月异,现在则越来越多地使用PCB作基板。连接两个独立焊盘的引线键合,其引线的材质、键合条件、键合位置(除连接芯片和基板外,还连接两个芯片,或两个基板)等都有很大的不同。
四、引线键合法(Wire Bonding):热压(Thermo-Compression)/超声波(Ultrasonic)/热超声波(Thermosonic)

图4. 引线键合法
将金属引线连接到焊盘的方法主要有三种:热压法(thermo-compression method),将焊盘和毛细管劈刀(类似毛细管状的移动金属引线的工具)通过加热、压缩进行连接的方法;超声波法(Ultrasonic),不加热,将超声波施加到毛细管劈刀上进行连接的方法;热超声波法(Thermosonic),同时使用加热和超声波的综合式方法。第一种是热压键合法,提前将芯片焊盘的温度加热到200℃左右,再提高毛细管劈刀尖端的温度,使其变成球状,通过毛细管劈刀向焊盘施加压力,从而将金属引线连接到焊盘上。
第二种超声波法(Ultrasonic)是在楔形劈刀(Wedge,与毛细管劈刀类似,是移动金属引线的工具,但不形成球状)上施加超声波,实现金属引线与焊盘连接的方法。这种方法的优点是工艺和材料成本低;但由于超声波法用易操作的超声波代替了加热和加压的过程,因此键合拉伸强度(bonded tensile strength,连线后拽拉引线时的承受能力)则相对较弱。
半导体工艺中最常用的方法其实是第三种热超声波法。它结合了热压法和超声波法的优点。热超声波法将热、压力和超声波施加于毛细管劈刀,使其在最佳状态下进行连接。在半导体的后端工艺中,相比成本,键合的强度更加重要,因此尽管这一方法的成本相对较高,但金丝热超声波法是最经常采用的键合方法。
五、键合金属引线的材质:金(Au)/铝(Al)/铜(Cu)
金属引线的材质是根据综合考虑各种焊接参数(parameter),并组合成最妥当的方法来决定的。这里指的参数所涉及的事项繁多,包括半导体的产品类型、封装种类、焊盘大小、金属引线直径、焊接方法,以及金属引线的抗拉强度和伸长率等有关信赖度的指标。典型的金属引线材质有金(Au)、铝(Al)和铜(Cu)。其中,金丝多用于半导体的封装。
金丝(Gold Wire)的导电性好,且化学性很稳定,耐腐蚀能力也很强。然而,早期多使用的铝丝的最大缺点就是易腐蚀。而且金丝的硬度强,因此,在一次键合中可以很好地形成球状,并能在二次键合中恰到好处地形成半圆形引线环(Loop,从一次键合到二次键合金丝形成的形状)。
铝丝(Aluminum Wire)比金丝直径更大,间距(pitch)也更大。因此,即使使用高纯度的金丝形成引线环也不会断裂,但纯铝丝则很容易断裂,所以会掺和一些硅或镁等制成合金后使用。铝丝主要用于高温封装(如 Hermetic)或超声波法等无法使用金丝的地方。
铜丝(Copper Wire)虽价格便宜,但硬度太高。如果硬度过高,不容易形成球状,且形成引线环时也有很多限制。而且,在球键合过程中要向芯片焊盘施加压力,如果硬度过高,此时,焊盘底部的薄膜会出现裂纹。此外,还会出现牢固连接的焊盘层脱落的“剥落(Peeling)”现象。尽管如此,由于芯片的金属布线都是由铜制成的,所以如今越来越倾向于使用铜丝。当然,为了克服铜丝的缺点,通常会掺和少量的其他材质形成合金后使用。
六、材质不同,引线键合法也不同:金丝VS铝丝
引线键合中毛细管劈刀可以说是最核心的工具。毛细管劈刀,一般使用金丝,楔形键合则使用铝丝。毛细管劈刀是通过形成球状来实现键合的,而楔形键合则无需形成球状。楔形劈刀从形状上就与晶圆末端的毛细管劈刀不同,且连接和切断(tear)引线的方法也不同。
如果说金丝采用的是“热超声波-毛细管劈刀-球”的引线键合法,铝丝采用的则是铝丝楔形引线键合法(Aluminum Wedge Wire Bonding),即“超声波-楔形键合“的方法。铝丝—超声波法由于抗拉强度低,只能在特殊情况下使用,而90%以上的情况采用的都是“金丝-热超声波法”。当然,热超声波法也存在缺点,即球颈(ball neck)脆弱。所以要非常谨慎地管理HAZ(Heat Affected Zone,在金属引线材质被毛细管的高温稍熔化后,在凝固过程中再结晶的金属引线区域)。
七、利用金丝(Gold Wire)的球键合(Ball Bonding)

图5. 一次键合:在芯片焊盘上的球引线键合(Ball Bonding)
最常使用的“热超声波金丝球键合法”(Thermosonic Gold Ball Wire Bonding),分为两个键合阶段。一次键合过程如下:金丝穿过毛细管劈刀正中央的小孔,提高金丝末端的温度,金丝融化后形成金丝球(Gold Ball),打开夹持金属丝的夹钳(用于收放金属引线),施加热、压力和超声波振动,当毛细管劈刀接触焊盘时,形成的金丝球会粘合到加热的焊盘上。完成一次球键合后,将毛细管劈刀提升到比预先测量的环路高度略高的位置,并移动到二次键合的焊盘上,则会形成一个引线环(loop)。

图6. 二次键合:PCB焊盘上的针脚式键合(stitch bonding)
二次键合过程如下:向毛细管劈刀施加热、压力和超声波振动,并将第二次形成的金丝球碾压在PCB焊盘上,完成针脚式键合(stitch bonding)。针脚式键合后,当引线连续断裂时,进行拉尾线(Tail Bonding),以形成一尾线(wire tail)。之后,收紧毛细管劈刀的夹钳(即夹住引线)、断开金属引线,结束二次金丝球键合。
今天,我们主要讲了引线键合法与材质之间的相互作用,以及引线键合的具体方法。在本文中,对可靠性和引线键合中可能出现的问题只是进行了简短的介绍,但要铭记,在引线键合过程中,发现问题,并找出克服问题的解决方案,理解相互之间的权衡关系是非常重要的。我还建议读者可以了解一下,封装种类及技术的进步,给键合方法带来了什么样的变化。

陈锺文半导体专栏作家
韩国忠北半导体高等学校老师








